ニコンウェハエッジ検査装置「WES-3000」シリーズの発売について
デバイスウェハのエッジを高速検査して高解像度でレビューが可能
2008年11月27日PRESS RELEASE/報道資料
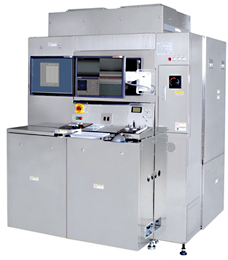
株式会社ニコン(社長:苅谷道郎)は、ウェハエッジの欠けや傷、デバイス製造のプロセスで発生する膜のはがれや残留物といった欠陥を高速で検出して、高精細・高解像カラー画像で欠陥箇所を確認できるウェハエッジ検査装置「WES-3000」シリーズを2008年12月3日より発売します。なお本製品は、12月3日から5日まで幕張メッセ(日本コンベンションセンター:千葉市美浜区)で開催される「セミコン・ジャパン2008」にパネル展示の予定です。
発売概要
| 商品名 | ニコンウェハエッジ検査装置「WES-3000」シリーズ |
|---|---|
| 価格 | 1.0億円~(仕様により異なります) |
| 発売予定日 | 2008年12月3日 |
発売のねらい
ウェハサイズの大口径化や、チップサイズの縮小化でウェハ周縁部の余剰領域が減り、ウェハ周縁部でのチップ製造数も増加しています。一方、露光プロセス微細化に伴う材料の変化、露光工程数の増加などにより、ウェハエッジの欠け、傷、膜のはがれや残留物といったデバイス欠陥も発生しています。
ウェハエッジに発生する欠陥によりICチップ製造の歩留りは低下しており、また最先端デバイスメーカーにおける液浸プロセス導入により、ウェハエッジの検査ニーズが高まっています。今回発売する製品は、ウェハエッジのインライン検査機として必要な高速で誤検出の少ない安定した検査と、検査結果とその欠陥を高精細・高解像度カラー画像で確認できる機能をあわせもったウェハエッジ検査装置です。
主な特長
1. 高精細・高解像度での欠陥確認が可能
ウェハの端面および周辺の傾斜部をベベルと呼びます。このベベル部分は、デバイスメーカーやプロセスにより形状も異なっています。これらを高精細・高解像度で撮像するためには、専用の照明系・光学系が必要となります。「WES-3000」シリーズでは、長年培ってきた光学技術を結集して、レビュー時分解能1マイクロメートルという高精細・高解像度での欠陥検出部位の再現を可能にしました。
2. 画像処理技術を用いた高速インライン検査が可能
装置内でウェハ側面の観察が可能な場所に、ラインCCDを取り付け、スキャンした画像データに対して、ニコンが独自に開発した画像処理技術を施すことによって、300ミリウェハ毎時100枚の高速検査を実現しました。また、ウェハエッジの欠け、傷といった検出が比較的容易な欠陥だけでなく、デバイス特有の膜のはがれや残留物といった検出に時間・コストを要していた欠陥検出も、分解能4マイクロメートルでの高速インライン検査を実現しました。
3. 最新のウェハエッジ検査に必須の充実したアプリケーション機能(オプション)
ウェハエッジに発生する欠陥は、一定以上の大きさの欠けなど次の工程に回すべきでないものから、膜荒れや、膜内部の気泡のようにすぐには重大な欠陥とならないものまで多岐に渡ります。これらの欠陥は、良否の判定のみではなく、欠陥検出データにもとづいた分類・分析を行う必要があります。そのためウェハエッジの欠陥特定と対応の優先順位付けを可能にする下記アプリケーションソフトの開発をすすめています。
- ビューアー機能:ウェハの全外周(360度)をモニター上で一望することが可能。
- 簡易ADC(Auto Defect Classification):検出した欠陥の自動欠陥分類が可能。
- 統計トレンドデータ:欠陥データを蓄積し、欠陥傾向をモニターすることが可能。
- Pre/Post表示: それぞれの製造工程で発生した欠陥表示が可能。
こちらに掲載されている情報は、発表日現在の情報です。販売が既に終了している製品や、組織の変更等、最新の情報と異なる場合がありますのでご了承ください。
